
2026 年 5 月 5-7 日,聚焦東南亞半導體產業發展的國際盛會 ——SEMICON SEA 2026將在馬來西亞國際貿易展覽中心盛大啟幕。作為東南亞地區極具影響力的半導體專業展會,本屆展會匯聚全球領軍企業,圍繞先進封裝、晶圓制造等核心領域展開深度交流,是鏈接東南亞市場、洞察區域產業機遇的關鍵平臺。
銘賽科技此次攜半導體先進封裝解決方案亮相SEMICON,依托精密點膠、精密貼裝、水導激光三大產品線,覆蓋底部填充、芯片散熱貼裝、高硬脆材料精密加工等關鍵場景,同時展出多款自主研發的高穩定性流體控制與制程核心部件,為半導體先進制造提供可靠的設備支持。
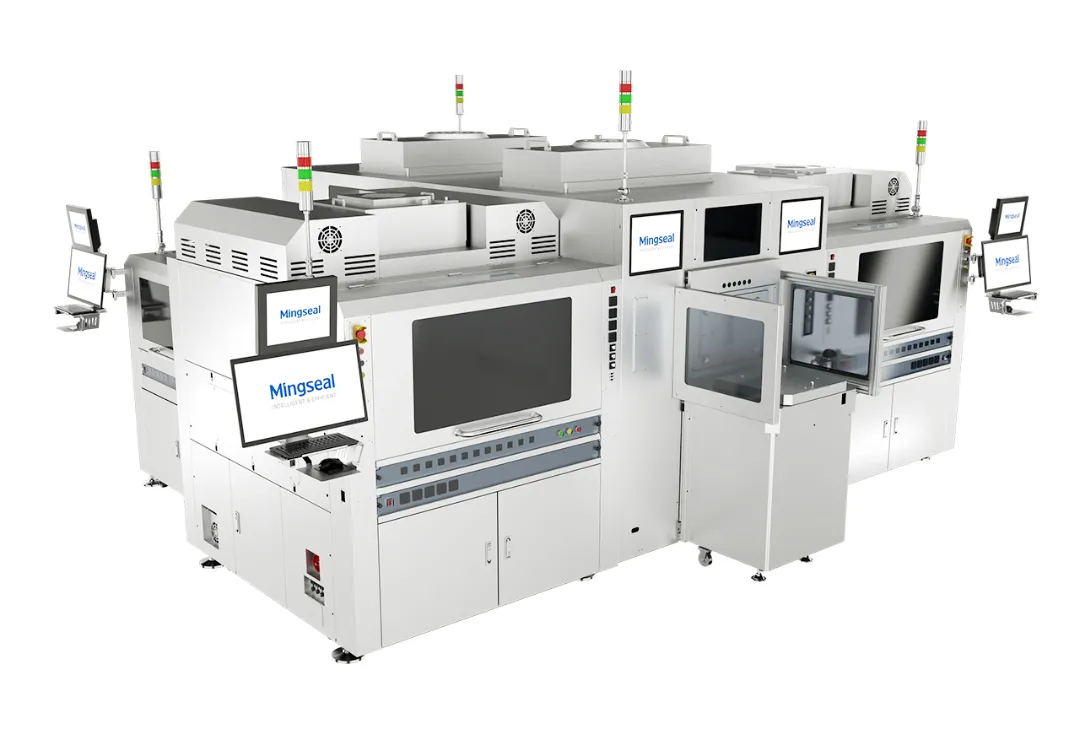
SS300 面板級點膠系統
專為RDL First FOPLP底部填充工藝打造的高穩定高精度Panel級點膠平臺,集自動上下料、對位、預熱、抗翹曲、噴膠、AOI 檢測于一體。支持PGV/AGV/OHT自動上下料,適配先進封裝產線的無人化、信息化管理需求。

SS101 晶圓級點膠系統
面向CoWoS、FoWLP等先進制程的晶圓級噴膠系統,集成晶圓自動上下料、預熱、加熱、噴膠、散熱全流程功能。配置AMHS機器人接口,滿足8/12 英寸晶圓規模化生產,適配晶圓級封裝的高精度、高穩定性要求。

GS600SUA 底部填充點膠機
專為 FCBGA、FCCSP、SiP 等倒裝芯片封裝的底部填充工藝設計,高精度全自動在線式噴膠設備。點膠精度達 ±0.02mm,礦物質框架結構保障高速運行穩定性;雙軌并行 + 三段加熱提升產線效率,支持 PDI 在線檢測、膠形 AOI 檢測,可對接 MES 系統,適配封裝企業量產需求。
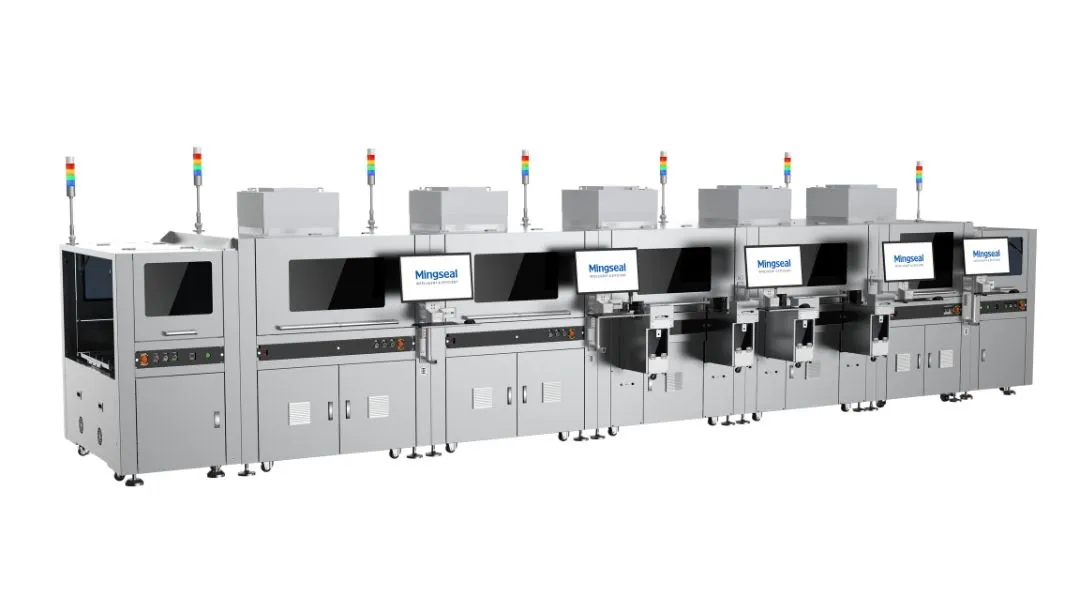
SS400 芯片散熱貼裝系統
針對TIM1/TIM2高效散熱場景,支持導熱硅脂、銦片、石墨烯、金剛石等多種散熱材料貼裝。兼容大尺寸 FCBGA、Q-Panel 連板作業,配套助焊劑噴涂、圍壩填充工藝,是功率器件、AI 芯片散熱集成的優選方案。

SS200 全自動散熱蓋貼裝系統
專為 FCBGA/FCCSP Lid Attach 工藝打造的高穩定性高精度貼裝系統,集自動上下料、AD/TIM 膠點膠、Lid 貼裝、保壓預固化、多環節檢測于一體,實現一站式自動化作業。具備點膠位置自動補償、智能防呆功能,模塊化設計支持多種選配模塊,兼容多種上料方式,適配多樣化產線需求。

MLS300 超精密加工系統
面向陶瓷、碳化硅、金剛石等高硬脆材料,提供平面高精密開槽、打孔、切割等加工方案,滿足先進封裝與功率器件制造的材料加工需求。加工精度達±10μm、熱影響區≤5μm、最小切割縫隙僅30μm,突破傳統加工技術局限,實現材料無毛刺、高質量加工。
半導體精密制造的價值,在于對制程穩定性與一致性的極致堅守。銘賽科技持續深耕半導體封裝與高端裝備領域,不斷實現精度、效率與可靠性的迭代突破。我們期待與東南亞及全球業界伙伴深入交流、攜手合作,共同把握半導體封裝領域的發展機遇!
時間:2026年5月5-7日
地點:馬來西亞國際貿易展覽中心(MITEC),吉隆坡
展位號:2216,Hall 8
